TSMC разработала прямое водяное охлаждение чипов на 2600 Вт

Эффективность трёх методов водяного охлаждения на разной скорости потока
Каждые несколько лет какой-нибудь крупный производитель процессоров или научный коллектив предлагает новые радикальные идеи охлаждения микросхем. Плотность интеграции в многочиповых конструкциях делает охлаждение всё более сложным. Во многих областях жидкостное охлаждение является единственным способом отвода тепла.
На конференции VLSI Technology and Circuits 2021 компания TSMC рассказала о своих достижениях в этой области (доклад «Ultra High Power Cooling Solution for 3D-ICs»: реферат, слайды). Там говорится, что инженеры разработали «эффективное решение для отвода более 2600 Вт отработанного тепла с большой интегральной схемы, что соответствует плотности 4,8 Вт/мм2».
«Низкотемпературное соединение логического чипа с кремниевой крышкой, с траншейной/решётчатой структурой охлаждения, врезанной в кремниевую крышку, позволяет свести к минимуму тепловое сопротивление между активным устройством и охлаждающей водой и наилучшую эффективность охлаждения, — сказано в реферате доклада. — Также было продемонстрировано прямое водяное охлаждение на обратной стороне кремния с плотностью теплоотвода более 7 Вт/мм2».
Прямое водяное охлаждение — практически неизбежное будущее микроэлектроники, если учесть постоянный рост TDP и переход на 3D-компоновку чипов. Это дело ближайшего времени. Например, AMD начнёт использовать 3D V-Cache в качестве дополнительной SRAM для процессоров Ryzen с конца 2021 — начала 2022 года.

Технология AMD 3D V-Cache
Дополнительный кэш расположен непосредственно над существующим кэшем L3, а не над ядрами Zen 3, что затрудняет их охлаждение. Но этим 3D-стекинг не ограничивается. Планируются всё более сложные соединения, и там уже требования к теплоотводу сильно вырастут.
В презентации TSMC говорится, что технология TSMC SoIC (System on Integrated Chips) совместима с микросхемами разных размеров, функциональности и доступна на кремниевых подложках разного диаметра.

Уже сейчас разработаны решения с плотностью теплоотвода 4,8 и 7 Вт/мм2, но в планах компании увеличить плотность теплоотвода (Thermal Power Density) более 10 Вт/мм2, уменьшить термическое сопротивление менее 10 K·мм2/Вт.
Предположительно, требования к теплоотводу будущих микропроцессоров превысят 2000 Вт на площади более 500 мм2).
TSMC описывает три способа встроить прямое охлаждение в чип:
- DWC (прямое водяное охлаждение): каналы для водяного охлаждения встроены непосредственно в верхние кремниевые слои чипа.
- Крышка Si с OX TIM: водяное охлаждение встроено в собственный слой кремния, который, в свою очередь, объединяется с чипом с использованием OX (Silicon Oxide Fusion) в качестве материала термоинтерфейса (TIM).
- Крышка Si с LMT: вместо слоя OX используется жидкометаллический термоинтерфейс (LMT)

Три способа прямого охлаждения 3D-микросхем
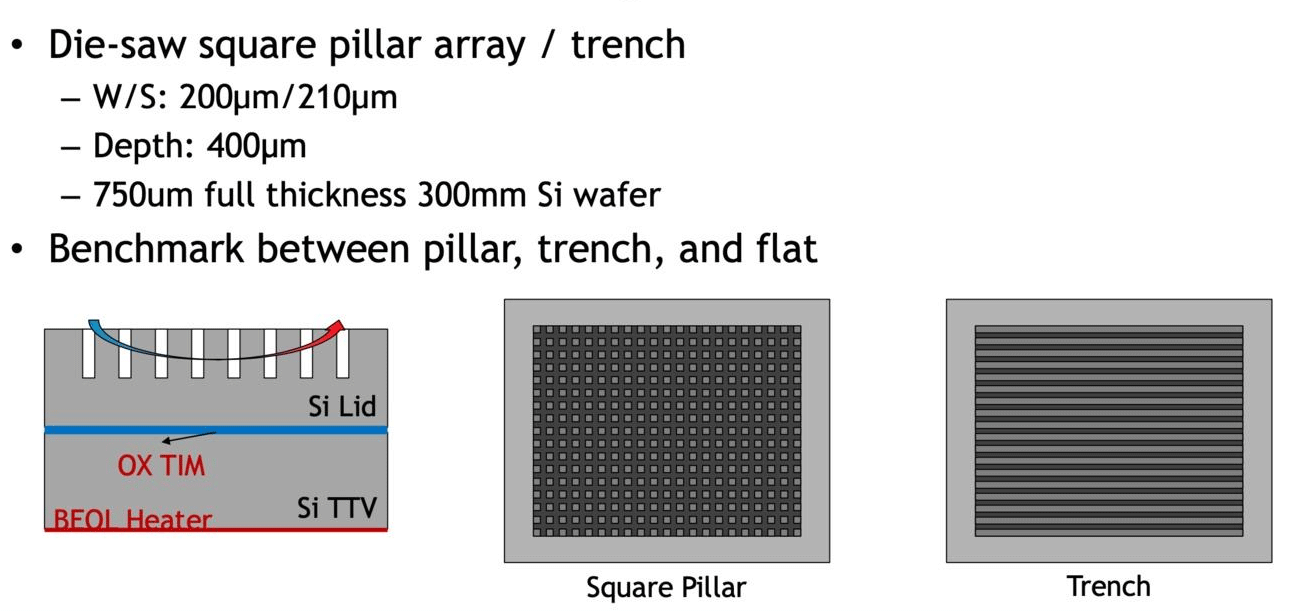
Для врезки каналов в кремний применяется стандартная технология резки, которая также используется для резки слитков монокристаллического кремния на пластины и разрезания самих пластин на отдельные микросхемы. В данном случае алмазный круг прорезает каналы шириной от 200 до 210 мкм и глубиной 400 мкм. Толщина кремниевого слоя составляет 750 мкм для пластины толщиной 300 мм. Этот слой должен быть как можно более тонким, чтобы упростить передачу тепла от активного чипа под ним.
Экспериментальная установка с медным нагревательным элементом выглядела следующим образом:

Площадь нагревательного элемента 540 мм2, общая площадь 780 мм2. Установка позволяет подавать электричество, подавать и отводить воду, а также подключать датчики. Воду вводили при постоянной температуре 25° C.
Результаты эксперимента показаны в таблице на КДПВ. Как видим, наилучшую эффективность показал вариант прямого водяного охлаждения с теплоотводом от микросхемы 2600 Вт при разнице температур 63° C и скоростью потока 5,8 литров в минуту.

Соотношение теплоотвода и скорости потока (литров в минуту) для разной конфигурации каналов
TSMC считает вполне возможным, что в будущих чипах будет реализовано прямое водяное охлаждение, без металлического кулера, когда вода подаётся напрямую на слой кремния. Таким образом можно отвести несколько киловатт отработанного тепла с одной микросхемы. Может пройти некоторое время, прежде чем мы увидим такое решение на практике.
Интересно подумать о том, какие продукты потребуют такого охлаждения в будущем. Маловероятно, что CPU первыми достигнут этих высот. Даже GPU добрались пока только до 500 и 600 Вт (Nvidia A100 и Intel Ponte Vecchio), им ещё развиваться и развиваться даже до скромного показателя 1000 Вт, не говоря уже о 2600 Вт.
Система теплоотвода 2600 Вт сегодня кажется излишеством для любого разумного потребительского продукта. Однако TDP микросхем почти не снижается, а переход на 3D-компоновку требует радикального пересмотра существующих стратегий охлаждения в долгосрочной перспективе.

