Intel рассказала о первом гибридном процессоре Lakefield
Компания Intel заинтересовала общественность новым решением, которое использует принципы мобильных SoC, что должно позволить ей успешно конкурировать с Qualcomm на рынке подключённых ноутбуков.
Процессор Lakefield имеет новую конструкцию Foveros 3D, которая предусматривает многослойное размещение элементов в одном пакете, что создаёт настоящую систему-на-чипе. Базовый слой пакета отвечает за средства ввода-вывода, интерфейсы и кэш, далее размещается вычислительный слой. На нём будет находиться 4 маломощных ядра и один большой CPU архитектуры Sunny Cove, что явно намекает на аналогию с big.LITTLE. Процессоры будут объединены с 1,5 МБ кэша L2 и 4 МБ кэша L3.
Стековая архитектура Lakefield 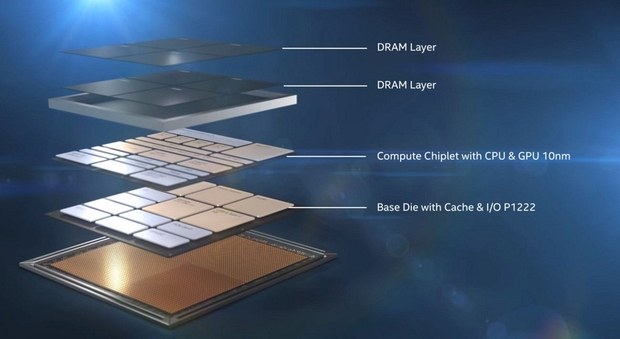 Габариты чипа Lakefield
Габариты чипа Lakefield 
Поверх процессора будет расположен слой графики, включающий Intel Graphics Gen 11-Low Power (Gen 11-LP), процессор дисплея Gen 11.5, процессор изображений, интерфейс дисплея MIPI, последовательный интерфейс камеры, DisplayPort 1.4, а также прочие интерфейсы для отладки.
Материнская плата для SoC Lakefield 
Замыкают вычислительный стек слои оперативной памяти LP-DDR4, объём которой не называется.
Макеты устройств с процессорами Lakefield 
Поскольку все компоненты компьютера будут упакованы в один чип, SoC Lakefield позволит значительно уменьшить габариты материнской платы и снизить энергопотребление машины. Компания ожидает, что новые SoC лягут в основу мощных и ультрапортативных устройств с двумя экранами, концепты которых показаны в видеоролике.
Ожидается, что устройства на базе Lakefield появятся уже в текущем году.
Полный текст статьи читайте на nvWorld.ru
